Wat is Ball Grid Array (BGA)?Voordelen, typen, montageproces
2025-08-25
11699
Catalogus

Figuur 1. Balletarray (BGA)
Wat is een balletarray (BGA)?
Een BGA- of Ball Grid -array is een type chipverpakking dat wordt gebruikt om geïntegreerde circuits (IC's) rechtstreeks op een gedrukte printplaat (PCB) aan te sluiten.In plaats van pennen heeft BGA veel kleine soldeerballen gerangschikt in een raster aan de onderkant.Wanneer verwarmd, smelten deze soldeerballen en bevestigen ze de chip aan het bord, waardoor zowel de fysieke binding als de elektrische verbindingen worden gecreëerd.Omdat het hele onderoppervlak wordt gebruikt voor verbindingen, kan BGA's veel meer verbindingen in een kleine ruimte passen in vergelijking met oudere pin-gebaseerde pakketten.
BGA's zijn ook beter in het snel dragen van elektrische signalen en het verspreiden van warmte, zodat de chip sneller kan lopen en koeler blijft.BGA's worden veel gebruikt in moderne apparaten zoals microprocessors, grafische kaarten en andere krachtige elektronica waar compacte grootte, snelheid en betrouwbaarheid nodig zijn.
Hoe Ball Grid Array (BGA) -pakketten werken
Ball Grid Array (BGA) werkt met behulp van kleine soldeerballen aan de onderkant van de chip om deze aan te sluiten op de printplaat (PCB).Elke soldeerkal komt overeen met een klein pad op het bord.Wanneer de chip op het bord wordt geplaatst en in een speciale oven wordt verwarmd, smelten de soldeerballen aan de kussens.Na het afkoelen wordt het soldeer weer solide, waardoor sterke elektrische paden ontstaan en de chip stevig op zijn plaats houden.Een slim ding over BGA's is dat het gesmolten soldeer de chip "zelfinspannings" helpt.Dit betekent dat de chip zichzelf tijdens het verwarmen in de juiste positie kan aanpassen, wat fouten vermindert die plaatsvinden met oudere pin-gebaseerde chips.
Met soldeerkallen gelijkmatig verspreid, signalen sneller reizen, wordt het geluid verminderd en beweegt de warmte naar het bord om de chipkoeler te houden.En omdat de soldeerverbindingen onder de chip zijn verborgen, kunnen ze niet direct worden gezien.Om te controleren of de verbindingen goed zijn, zijn speciale gereedschappen zoals röntgenmachines vereist.Als er een probleem gebeurt, vereist het repareren of vervangen van een BGA -chip speciale apparatuur, waardoor reparatie moeilijker wordt dan oudere soorten pakketten.
Waarom kiezen voor Ball Grid Array (BGA) -pakketten

Figuur 2. Balrooster array (BGA) onderkant
Ball Grid Array (BGA) -pakketten hebben de voorkeur omdat ze veel problemen oplossen die worden gevonden in oudere chipontwerpen zoals Quad Flat Packs (QFPS).In QFP's verbindt de chip met het bord via zeer dunne pinnen die dicht langs de randen worden geplaatst.Deze pennen kunnen gemakkelijk buigen of breken, wat reparaties hard en duur maakt.De smalle afstand verhoogt ook het risico op fouten tijdens het solderen, zoals spelden die elkaar aanraken en het circuit falen.Bovendien maken de drukke pinnen het moeilijk om de printplaat (PCB) te ontwerpen, omdat het routeren van alle paden eromheen leidt tot verstopping en beperkt de prestaties.
BGAS lost deze problemen op door kleine soldeerballen aan de onderkant van de chip te gebruiken in plaats van delicate pennen.Deze soldeerballen zijn sterker en zijn minder kans om te beschadigen, terwijl ze ook meer vrijheid geven in het PCB -ontwerp omdat de verbindingen zich over het hele onderoppervlak verspreiden.Het zelfuitlijningsfunctie van BGA's maakt het proces eenvoudiger en verbetert de algehele kwaliteit van de verbinding.Om deze redenen zijn BGA -pakketten de standaard en de beste keuze in moderne elektronica geworden.
Voordelen van Ball Grid Array (BGA) -pakketten
• Meer verbindingen in kleine ruimtes - BGA's gebruiken de hele bodem van de chip voor soldeerballen, niet alleen de randen.Dit maakt veel verbindingen mogelijk zonder de chip groter te maken.
• Betere signaalprestaties - De soldeerballen in BGA's zijn kort en breed, wat het pad voor signalen soepeler maakt.Dit vermindert problemen zoals vertraging, weerstand en interferentie.Dit helpt de chip beter en betrouwbaarder te werken.
• Goede warmtecontrole - Chips kunnen erg heet worden als ze snel rennen.BGA's helpen de warmte gelijkmatig in de printplaat te verspreiden en het bord draagt de warmte weg.Dit houdt de chip koeler en laat hem werken met hogere snelheden zonder oververhit te raken.
• Sterke en betrouwbare gewrichten - Old-stijl pinnen kunnen buigen, breken of problemen veroorzaken wanneer ze worden gesoldeerd.BGA's hebben dit probleem niet omdat de soldeerballen sterker zijn en niet buigen.Wanneer verwarmd, smelt het soldeer en trekt de chip op de juiste plaats, waardoor de verbinding veiliger en langdurig is.
• gemakkelijker printplaatontwerp - Omdat de ballen onder de chip worden verspreid, is de printplaat minder druk.Dit maakt het gemakkelijker om fouten te ontwerpen en vermindert.
• Klein en licht - BGA -pakketten zijn kleiner en lichter in vergelijking met oudere ontwerpen zoals QFP.Dit maakt ze geweldig voor draagbare apparaten zoals laptops, tablets en smartphones, waar het besparen van ruimte en gewicht vereist is.
Balletarray (BGA) -typen
Balletarrays worden in vele soorten geleverd, elk gemaakt voor specifieke behoeften zoals grootte, warmtebestrijding, kosten of prestaties.Hieronder staan de meest voorkomende met hun belangrijkste kenmerken en korte beschrijvingen:
Tape Ball Grid Array (TBGA) - Dit type gebruikt een dunne tape-achtige basis om de chip- en soldeerballen te ondersteunen.TBGA is licht, flexibel en beheert warmte goed, waardoor het geschikt is voor compacte elektronica waar ruimte en koeling nodig zijn.
Enhanced Ball Grid Array (EBGA) - Gemaakt met een mix van organische en keramische materialen, eBGA's bieden een sterke thermische regeling, betrouwbare signaalstroom en vaste mechanische sterkte.Ze worden gekozen voor veeleisende toepassingen zoals processors en grafische eenheden.
Metal Ball Grid Array (MBGA) - Met een metalen kern als basis leveren MBGA's een uitstekende duurzaamheid en warmtespreiding.Ze zijn het beste voor omgevingen met zware thermische belastingen of extra stabiliteit vereisen.
Plastic Ball Grid Array (PBGA) - PBGA's gebruiken een plastic basis, waarbij ze lichtgewicht en kostenvriendelijk houden.Ze zijn populair in consumentengadgets, autosystemen en telecomapparatuur omdat ze de prijs in evenwicht brengen met betrouwbare prestaties.
Keramische balrooster array (CBGA) - CBGA's zijn afhankelijk van een keramische basis en biedt een hoge stabiliteit en betrouwbaarheid in extreme omstandigheden.CBGA's worden gebruikt in ruimtevaart, verdediging en medische apparatuur waar langdurige duurzaamheid een must is.
Gieten array -proces BGA (MAPBGA) - Deze optie is economisch en compact, ontworpen voor apparaten die een betrouwbare werking nodig hebben, maar niet extreme prestaties.MAPBGA is praktisch voor elektronica met lage tot middellange afstand vanwege het kleine formaat en eenvoudige montageproces.
Thermisch verbeterde PBGA (TEPBGA) - Door dikke koperen vlakken aan de basis toe te voegen, kan tepbgas snel warmte wegtrekken.Ze zijn ideaal voor chips die veel thermische energie produceren en efficiënte koeling nodig hebben.
Pakket op pakket (pop) - POP -technologie stapelt meerdere chips op elkaar, zoals het plaatsen van geheugen boven een processor.Dit bespaart ruimte en verhoogt de functionaliteit, wat vooral is in smartphones en tablets.
Micro BGA (µBGA) - Deze miniatuurversie is gebouwd met zeer fijne toonhoogte, soms minder dan 1 mm.µBGA is ontworpen voor ultra-kleine apparaten zoals wearables en andere zeer compacte elektronica.
Ball Grid Array (BGA) assemblageproces
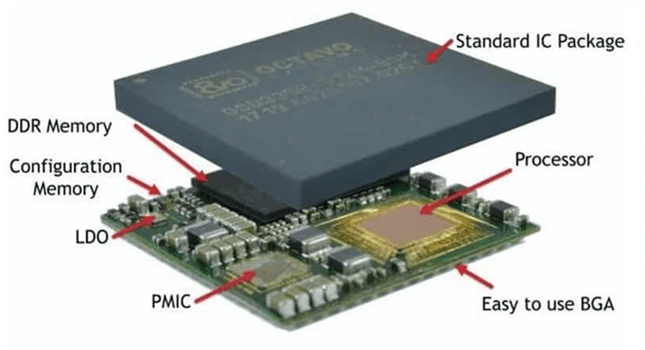
Figuur 3. BGA -pakket en componenten lay -out
Toen BGA-pakketten voor het eerst werden geïntroduceerd, maakten veel mensen zich zorgen over hoe ze ze kunnen monteren, omdat de verbindingen onder de chip verborgen zijn, in tegenstelling tot oudere oppervlaktemontagepakketten met zichtbare pinnen.In eerste instantie gooide dit twijfels over hun betrouwbaarheid, maar al snel werd bewezen dat Reflow Soldering heel goed werkt voor BGA's.
In dit proces wordt de hele printplaat, inclusief de BGA, op een gecontroleerde manier verwarmd.De soldeerballen onder de chip zijn al bedekt met de juiste hoeveelheid soldeer, en wanneer de temperatuur stijgt, smelten ze en vormen ze sterke verbindingen met de kussens op het bord.Een natuurlijk effect dat oppervlaktespanning wordt genoemd, helpt de chip zichzelf in perfecte uitlijning te trekken, waardoor de soldeerballen overeenkomen met de pads.Terwijl het soldeer afkoelt, blijft het kort deels vloeibaar, waardoor elke bal zich goed kan vestigen zonder zijn buren aan te raken.Zorgvuldige temperatuurregeling en de rechter soldeerlegering garanderen betrouwbare en afzonderlijke gewrichten.
Uiteindelijk is dit proces verbeterd en gestandaardiseerd, dus BGA -assemblage is nu een groot deel van de productie van elektronica.Nu worden BGA's gezien als betrouwbare, nauwkeurige en effectieve pakketten die helpen bij het maken van compacte en krachtige elektronische apparaten.
Ball Grid Array (BGA) -pakketten Toepassingen
Ball Grid Array (BGA) -pakketten komen veel voor in de elektronica van vandaag omdat ze sterke chips in kleine ruimtes laten passen en nog steeds goed werken.Hieronder staan de array -toepassingen van de balrooster:
Microprocessors en CPU's - Zorg voor snelle verwerking en betrouwbare prestaties in computers, servers en ingebedde systemen.
Grafische processors (GPU's) - Behandel grote hoeveelheden gegevens en warmte in gameconsoles, laptops en grafische kaarten.
Geheugenapparaten - Gebruikt in RAM, flash -geheugen en andere opslagmodules om de bordruimte op te slaan en tegelijkertijd de prestaties hoog te houden.
Consumentenelektronica - Gevonden in smartphones, tablets, laptops en smart -tv's waar compacte grootte en efficiëntie nodig zijn.
Telecommunicatieapparatuur - Zorg voor snelle en stabiele signaaloverdracht in netwerksystemen en communicatieapparaten.
Auto -systemen - Ondersteuning van Advanced Driver-Assistance Systems (ADAS), infotainment- en controlemodules met betrouwbare verbindingen.
Medische apparatuur - Gebruikt in apparaten die precisie en duurzaamheid vereisen, zoals beeldvormingssystemen en monitoringtools.
Ruimtevaart en verdediging - Zorg voor sterke thermische en mechanische stabiliteit in harde omgevingen.
Common Ball Grid Array (BGA) problemen en oplossingen
Gebarsten gewrichten - Scheuren kunnen zich vormen in soldeerballen als gevolg van herhaalde verwarming en koeling, of door mechanische stress zoals buigen of trillingen.Gebruik sterkere soldeerlegeringen, voeg underfill -materialen toe voor ondersteuning en ontwerpborden die de mechanische stress verminderen.
Zwakke soldeerverbindingen - Als het soldeer niet volledig smelt tijdens Reflow, kan het gewricht zwak zijn en slechte verbindingen veroorzaken.Controleer de reflowtemperatuur zorgvuldig en zorg ervoor dat de rechter soldeerpasta -hoeveelheid wordt toegepast.
Het overbruggen - Wanneer soldeerballen samen smelten, kunnen ze kortsluiting creëren tussen verbindingen.Breng de juiste dikte van de soldeerpasta aan, houd soldeerballen gelijkmatig op afstand en volg precieze verwarmingsprofielen.
VOIDS (AIR -zakken) - Luchtzakken of gas kunnen in het soldeer gevangen zitten, waardoor gewrichten zwakker en minder betrouwbaar worden.Gebruik de juiste soldeerpasta, reinig het PCB -oppervlak goed en optimaliseer het reflowproces om gevangen gas te verminderen.
Verkeerde uitlijning - Als de chip niet correct wordt geplaatst, mogen de soldeerballen niet overeenkomen met de PCB -pads.Gebruik geautomatiseerde pick-and-place machines en laat zelfuitlijning toe tijdens het verwarmen van reflow.
Moeilijk te inspecteren of te repareren - Omdat BGA -gewrichten onder het pakket verborgen zijn, is het moeilijk om problemen te zien en nog moeilijker om ze te repareren.Gebruik röntgeninspectie om soldeerverbindingen en speciale herwerktools te controleren voor het verwijderen en vervangen van defecte BGA's.
BGA versus andere IC -verpakkingstechnologieën
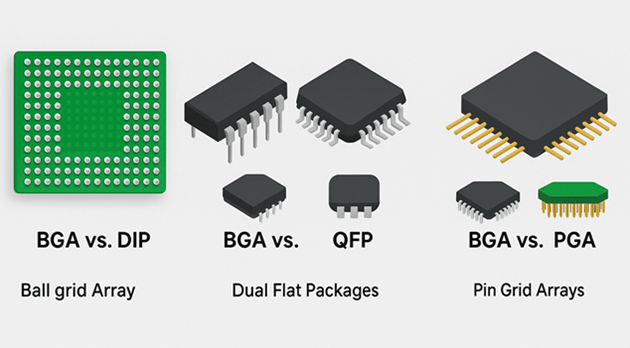
Figuur 4. BGA versus andere IC -verpakkingen
BGA vs. Dip
Dubbele in-line pakketten (DIP) hebben twee rijen pennen aan de zijkanten van de chip.Ze zijn goedkoop, gemakkelijk te gebruiken en goed voor eenvoudige elektronica, maar ze nemen meer ruimte in beslag en kunnen niet veel verbindingen aan.Ball Grid Array (BGA) chips gebruiken kleine soldeerballen onder het pakket, waardoor veel meer verbindingen mogelijk zijn terwijl de chip kleiner blijft.Dit maakt BGA's beter voor moderne elektronica waar spaarruimte vereist is.
BGA vs. QFP
Quad platte pakketten (QFP) gebruiken dunne pinnen die dicht bij elkaar rond de randen worden geplaatst.Deze pinnen buigen gemakkelijk en kunnen problemen veroorzaken tijdens het solderen omdat ze zo dichtbij zijn dat ze per ongeluk kunnen raken, wat leidt tot kort circuits.BGA's vermijden dit door soldeerballen onder de chip te plaatsen in plaats van pennen.De ballen zijn sterker, verspreid over de bodem en lijnen correct in lijn tijdens het verwarmen, waardoor betrouwbaardere verbindingen worden gegeven.
BGA vs. PGA
Pin Grid Arrays (PGA) hebben een raster van pinnen die uit de bodem uitsteken die op de sockets op het bord worden aangesloten.Ze zijn gemakkelijk te verwijderen en te vervangen, maar de pennen kunnen buigen of breken wanneer ze worden behandeld.BGA's verbinden rechtstreeks met het bord met soldeerkallen in plaats van pennen.Dit maakt de verbindingen moeilijker, verbetert de warmtestroom en helpt signalen sneller te bewegen, wat nodig is voor krachtige processors en grafische chips.
Conclusie
BGA's worden tegenwoordig veel gebruikt omdat ze veel verbindingen in een kleine ruimte passen, de warmtebestrijding verbeteren en betere prestaties geven.Ook al zijn ze moeilijker te controleren en te repareren, met de juiste gereedschappen die ze betrouwbaar werken.Van telefoons en laptops tot auto's en vliegtuigen, BGA's worden vertrouwd om apparaten kleiner, sterker en efficiënter te maken.
 OVER ONS
Klanttevredenheid elke keer.Wederzijds vertrouwen en gemeenschappelijke belangen.
OVER ONS
Klanttevredenheid elke keer.Wederzijds vertrouwen en gemeenschappelijke belangen.
Functietest.De hoogste kosteneffectieve producten en de beste service zijn onze eeuwige inzet.
Heet artikel
- LM358 Dubbele operationele versterker uitgebreide gids: pinouts, circuitdiagrammen, equivalenten, nuttige voorbeelden
- Zijn CR2032 en CR2016 uitwisselbaar?
- Inzicht in de verschillen ESP32 en ESP32-S3 Technische en prestatie-analyse
- De juiste batterij kiezen: een gids voor AG4, LR626, LR66, 177/376/377, SR626 en SR626SW Equivalents
- NPN vs. PNP: Wat is het verschil?
- Basisprincipes van transistor BC547: pin-out, applicatiecircuits, alternatieve/complementaire modellen
- ESP32 vs STM32: Welke microcontroller is beter voor u?
- Wat is een MOSFET en hoe het werkt?
- Elektrisch relais Basic: werkbewerking, typen en gebruik
- PNP -transistoren: structuur, werkingsprincipe en toepassing
 IC 7400 verkennen: specificaties, pin -configuratie en praktische toepassingen
IC 7400 verkennen: specificaties, pin -configuratie en praktische toepassingen
2024-09-09
 Uitgebreide gids voor stroomvoorziening circuits
Uitgebreide gids voor stroomvoorziening circuits
2024-09-06
Veel Gestelde Vragen [FAQ]
1. Wat is de levensduur van een BGA -pakket?
Een BGA-pakket kan 10-20 jaar duren in normale omstandigheden, afhankelijk van de kwaliteit van de assemblage en de omgeving waarin het werkt. Warmtecycli, trillingen en slechte soldeerpraktijken kunnen zijn levensduur verkorten, vooral in toepassingen met hoge stress zoals automotive of ruimtevaartelektronica.
2. Kunnen BGA -chips worden vervangen of herwerkt?
Ja, maar het vereist geavanceerde tools en vaardigheden.Gespecialiseerde apparatuur zoals hot-air herwerkingsstations en röntgeninspectiesystemen worden gebruikt om de oude chip te verwijderen, het bord schoon te maken en een nieuwe te solderen.
3. Waarom zijn BGA's moeilijker te repareren dan QFP's?
In QFP's zijn de pennen zichtbaar en kunnen ze indien nodig handmatig worden geredeerd.BGA's verbergen hun soldeerverbindingen onder het pakket, waardoor visuele inspectie en reparatie veel complexer en tijdrovend worden.
4. Wat gebeurt er als een BGA -soldeergewricht faalt?
Een mislukte soldeergewricht kan ervoor zorgen dat het apparaat willekeurige fouten weergeeft, prestaties verliezen of volledig stoppen met werken.In de meeste gevallen moet de chip worden gereball of vervangen om de volledige functie te herstellen.
5. Hoe wordt BGA Reballing gedaan?
Reballing omvat het verwijderen van oude soldeerballen, het reinigen van het oppervlak en het aanbrengen van nieuwe ballen met behulp van een stencil.Het pakket wordt vervolgens in een reflowoven verwarmd om de nieuwe ballen veilig aan de chip te binden.
Heet onderdeelnummer
 GJM1555C1HR90BB01D
GJM1555C1HR90BB01D GRM32DR71E475KA61K
GRM32DR71E475KA61K GRM0335C1H1R6CA01D
GRM0335C1H1R6CA01D C2012X5R0J335M/1.25
C2012X5R0J335M/1.25 LMK316AB7106ML-T
LMK316AB7106ML-T LD051A471KAB2A
LD051A471KAB2A AMK316BJ476ML-T
AMK316BJ476ML-T GRM1556P1H9R5DZ01D
GRM1556P1H9R5DZ01D GRM1555C1H2R0BZ01D
GRM1555C1H2R0BZ01D GRM1557U1H5R0CZ01D
GRM1557U1H5R0CZ01D
- T495X476K035AHE200
- LC4256ZE-5TN100C
- VSC7216XUI-02
- SI3015-KS
- S912ZVL64F0VLFR
- MLX91209LVA-CAA-000-SP
- PM150CFE060
- SA53488434
- VI-J02-CY/F2
- MC10H174FN
- T491X476M035ATZ166
- LT1963EFE-1.8#PBF
- FPF1504LUCX
- HMC510LP5E
- BAT54S
- TLK1201ARCPR
- T491D227K010AT4860
- ADUM3221BRZ
- AD7376ARUZ100-R7
- LTC3646EMSE#PBF
- XCS30XL-4TQ144I
- T491C107K010ATZ320
- K6X4016T3F-TF55
- ACS716-KLA-10CB-NL
- AD7266BCP
- ICS84320AY-01LN
- LM3431MH
- LM394CH
- LMV934MT
- MSP3411G-FH-A2
- MT41J256M8HX-15EAIT:D
- M3030RFDPGP#U5
- SLB9655TT12
- TGS2600
- TP4056M-42-EMSOP8
- TSUMOP887DT9-1
- WDT8858A-CQ2
- MP2731GQC-0000-Z
- BW-S8W2